[本站讯]近日,第36届功率半导体器件和集成电路国际会议(International Symposium on Power Semiconductor Devices and ICs, ISPSD)在德国不莱梅举行。集成电路学院刘超教授团队的研究论文“MOCVD Growth and Fabrication of Vertical P-i-N and Schottky Power Diodes Based on Ultra-wide Bandgap AlGaN Epitaxial Structures”在大会上发表。文章第一作者为集成电路学院2020级博士研究生陈航,通讯作者为刘超教授,合作作者为圆融光电科技股份有限公司杨天鹏、米亭亭、王小文。这是山东大学首次以第一作者和通讯作者单位在ISPSD会议发表论文。
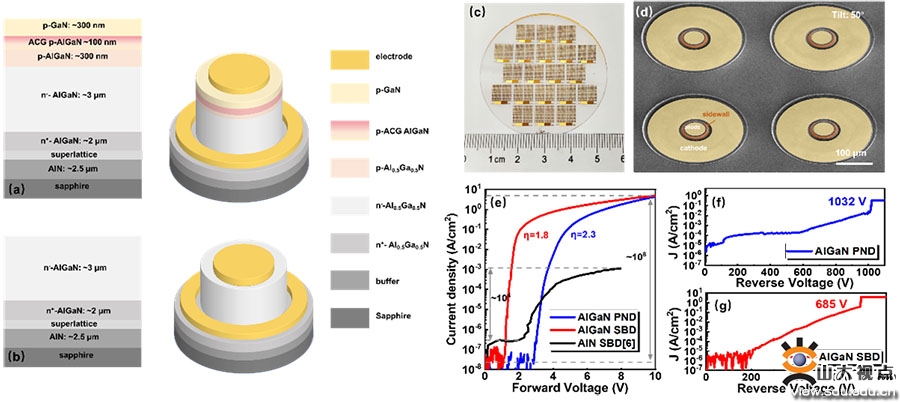
图1.基于超宽禁带半导体Al0.5Ga0.5N的垂直型P-i-N二极管与肖特基二极管(a)-(b)器件结构示意图,(c)-(d)器件实拍图片,(e)-(g)器件正反向I-V曲线
与传统的宽禁带半导体材料相比,超宽禁带半导体材料具有更大的禁带宽度、更高的击穿场强以及更优异的高温稳定性,在电力电子领域具有显著的优势和巨大的潜力。刘超教授团队基于III族氮化物材料体系的高铝组分铝镓氮(Al0.5Ga0.5N)材料,在蓝宝石衬底上生长并制备了垂直型功率P-i-N二极管与肖特基二极管,采用3微米厚的Al0.5Ga0.5N漂移层,在没有终端保护的情况下,分别实现了1032 V和685 V的击穿电压,这是目前已报道的垂直型AlGaN功率二极管的最高水平。相关技术已申请国家发明专利(2023118424731)。
与氧化镓、氮化铝等超宽禁带半导体相比,高铝组分Al0.5Ga0.5N具有如下特点:1.当Al组分达0.5时,AlGaN材料可实现约4.8 eV的超宽带隙和约8.7 MV/cm的临界击穿场强;2. n型和p型的Al0.5Ga0.5N单晶薄膜均可通过金属有机物化学气相沉积(MOCVD)系统外延生长,对实现全外延结构的超宽禁带双极型二极管以及功率晶体管器件至关重要;3.三元系AlGaN材料独有的极化掺杂效应有助于改善超宽禁带半导体材料的电导率;4.大尺寸、低成本异质衬底上的AlGaN外延技术以及器件制备工艺较为成熟。这项研究成果展示了超宽禁带Al0.5Ga0.5N材料在垂直型功率器件中的应用潜力,为高性能、高可靠性电力电子器件的开发与产业化提供了新的技术路线。课题组相关工作获得国家重点研发计划、国家自然科学基金、山东省自然科学基金、广东省自然科学基金、深圳市自然科学基金、山东大学齐鲁青年学者项目,以及晶体材料国家重点实验室高层次青年人才项目等的支持。
功率半导体器件和集成电路国际会议,作为IEEE旗下的功率半导体旗舰会议,涵盖了功率半导体器件、功率集成电路、功率集成、工艺、封装和应用等功率半导体领域的所有方面,是功率器件领域最具影响力和规模最大的顶级国际学术会议,被认为是功率半导体器件和集成电路领域的奥林匹克会议,是功率半导体龙头企业与学术科研机构进行学术交流、展示功率半导体前沿技术成果的重要平台。